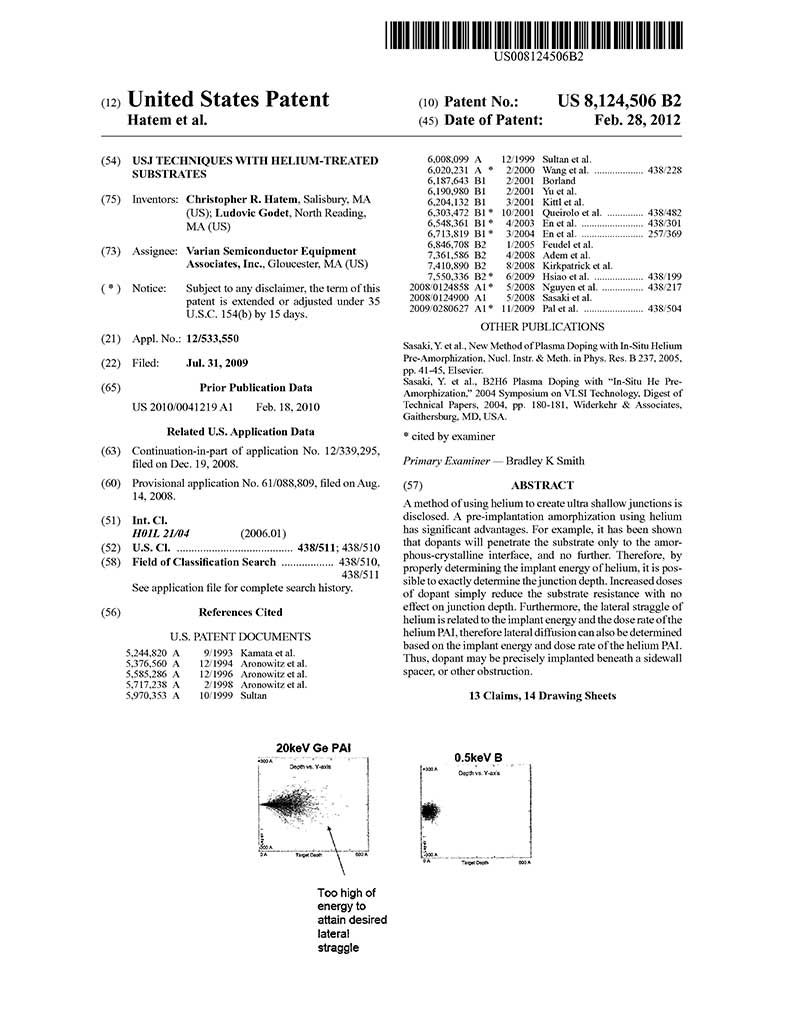
US 8,124,506: USJ techniques with helium-treated substrates
[Granted] A method of using helium to create ultra shallow junctions is disclosed. A pre-implantation amorphization using helium has significant advantages. For example, it has been shown that dopants will penetrate the substrate only to the amorphous-crystalline interface, and no further. Therefore, by properly determining the implant energy of helium, it is possible to exactly determine the junction depth. Increased doses of dopant simply reduce the substrate resistance with no effect on junction depth. Furthermore, the lateral straggle of helium is related to the implant energy and the dose rate of the helium PAI, therefore lateral diffusion can also be determined based on the implant energy and dose rate of the helium PAI. Thus, dopant may be precisely implanted beneath a sidewall spacer, or other obstruction.



Social Media