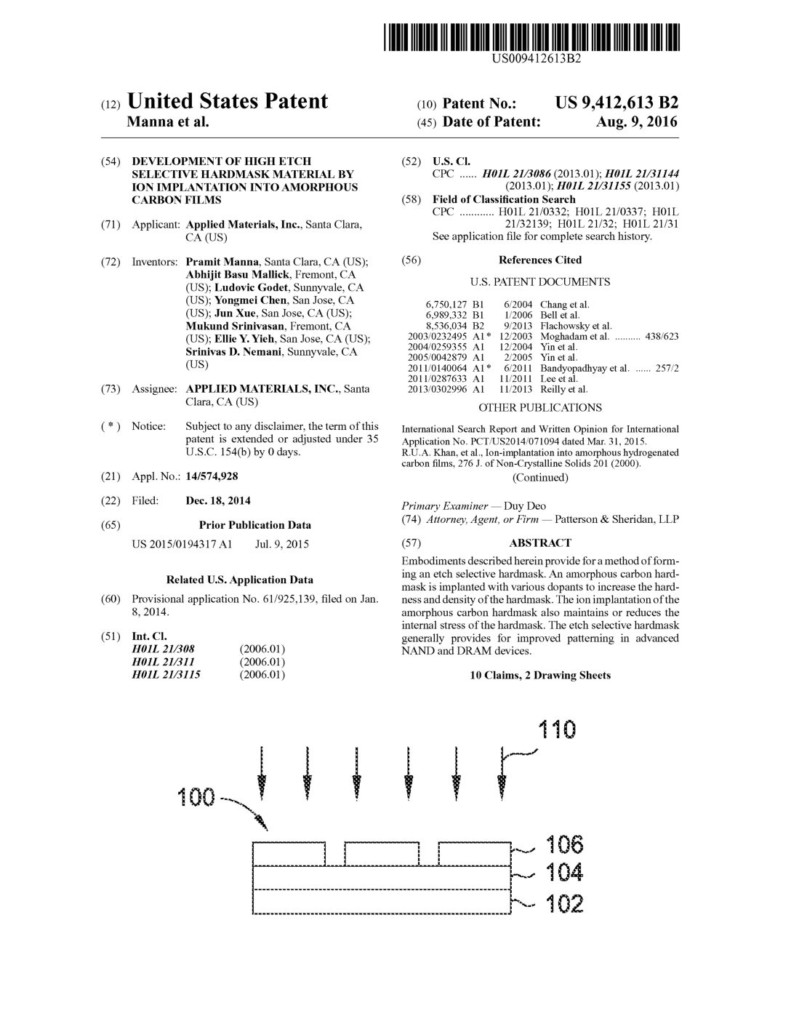
US 9,412,613: Development of High Etch Selectivity Hardmask by Ion Implantation in Carbon Films
Embodiments described herein provide for a method of forming an etch selective hardmask. An amorphous carbon hardmask is implanted with various dopants to increase the hardness and density of the hardmask. The ion implantation of the amorphous carbon hardmask also maintains or reduces the internal stress of the hardmask. The etch selective hardmask generally provides for improved patterning in advanced NAND and DRAM devices.



Social Media